MEMS制作工藝-太赫茲超導混頻陣列的MEMS體硅集成天線與封裝技術:
太赫茲波是天文探測領域的重要波段,太赫茲波探測對提升人類認知宇宙的能力有重要意義。太赫茲超導混頻接收機是具有代表性的高靈敏天文探測設備。天線及混頻芯片封裝是太赫茲接收前端系統的關鍵組件。當前,太赫茲超導接收機多采用單獨的金屬喇叭天線和金屬封裝,很難進行高集成度陣列擴展。大規模太赫茲陣列接收機發展很大程度受到天線及芯片封裝技術的制約。課題擬研究基于MEMS體硅工藝技術的適合大規模太赫茲超導接收陣列應用的0.4THz以上頻段高性能集成波紋喇叭天線,及該天線與超導混頻芯片一體化封裝。通過電磁場理論分析、電磁場數值建模與仿真、低溫超導實驗驗證等手段, 超聲芯片封裝采用三維堆疊技術,縮小尺寸 40% 并提升信噪比至 73.5dB,優化成像質量。福建MEMS微納米加工貨源充足
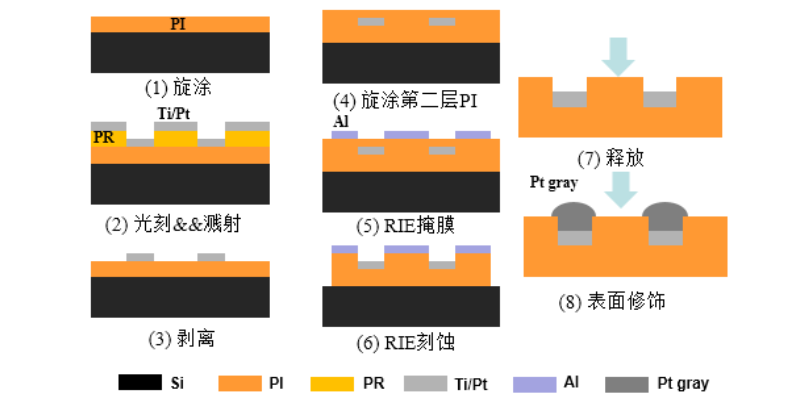
在腦科學與精細醫療領域,公司開發的MEA柔性電極采用超薄MEMS工藝,兼具物相容性與高導電性,可定制化設計“觸凸”電極陣列,***降低植入式腦機接口的手術創傷,同時提升神經信號采集的信噪比。針對藥物遞送與檢測需求,通過干濕結合刻蝕技術制備的微針器件,既可實現組織間液的無痛提取,又能集成電化學傳感功能,為糖尿病動態監測、透皮給藥系統提供硬件支持。此外,公司**的MEMS多重轉印工藝,可將光刻硅片模板快速轉化為PMMA、COC等硬質塑料芯片,支持10個工作日內完成從設計圖紙到塑料芯片成型的全流程,極大加速微流控產品的研發驗證周期。湖北MEMS微納米加工原料MEMS是一種現代化的制造技術。
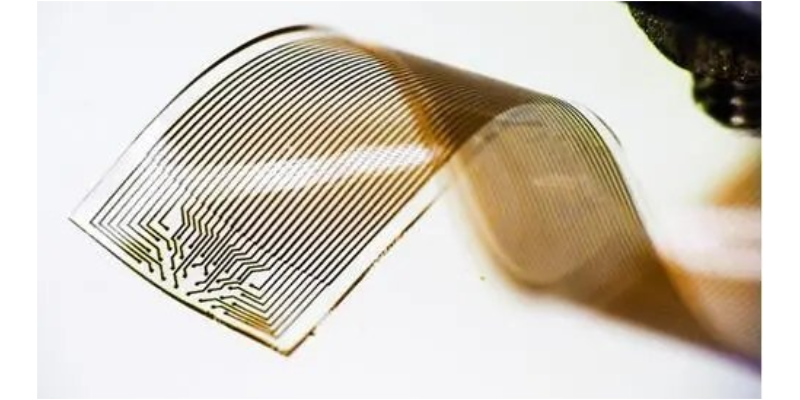
SU8微流控模具加工技術與精度控制:SU8作為負性光刻膠,廣泛應用于6英寸以下硅片、石英片的單套或套刻微流控模具加工,可實現5-500μm高度的三維結構制造。加工流程包括:基板清洗→底涂處理→SU8涂膠(轉速500-5000rpm,控制厚度1-500μm)→前烘→曝光(紫外光強度50-200mJ/cm2)→后烘→顯影(PGMEA溶液,時間1-10分鐘)。通過優化曝光劑量與顯影時間,可實現側壁垂直度>88°,**小線寬10μm,高度誤差<±2%。在多層套刻加工中,采用對準標記視覺識別系統(精度±1μm),確保上下層結構偏差<5μm,適用于復雜三維流道模具制備。該模具可用于PDMS模塑成型,復制精度達95%以上,流道表面粗糙度Ra<100nm。典型應用如細胞培養芯片模具,其微柱陣列(直徑50μm,高度200μm,間距100μm)可模擬細胞外基質環境,促進干細胞定向分化,細胞黏附率提升40%。公司具備從模具設計、加工到復制成型的全鏈條能力,支持SU8與硅、玻璃等多種基板的復合加工,為微流控芯片開發者提供了高精度、高性價比的模具解決方案。
MEMS制作工藝-聲表面波器件SAW:
聲表面波是一種沿物體表面傳播的彈性波,它能夠在兼作傳聲介質和電聲換能材料的壓電基底材料表面進行傳播。它是聲學和電子學相結合的一門邊緣學科。由于聲表面波的傳播速度比電磁波慢十萬倍,而且在它的傳播路徑上容易取樣和進行處理。因此,用聲表面波去模擬電子學的各種功能,能使電子器件實現超小型化和多功能化。隨著微機電系統(MEMS)技術的發展進步,聲表面波研究向諸多領域進行延伸研究。上世紀90年代,已經實現了利用聲表面波驅動固體。進入二十一世紀,聲表面波SAW在微流體應用研究取得了巨大的發展。應用聲表面波器件可以實現固體驅動、液滴驅動、微加熱、微粒集聚\混合、霧化。 MEMS 微納米加工技術是現代制造業中的關鍵領域,它能夠在微觀尺度上制造出高精度的器件。
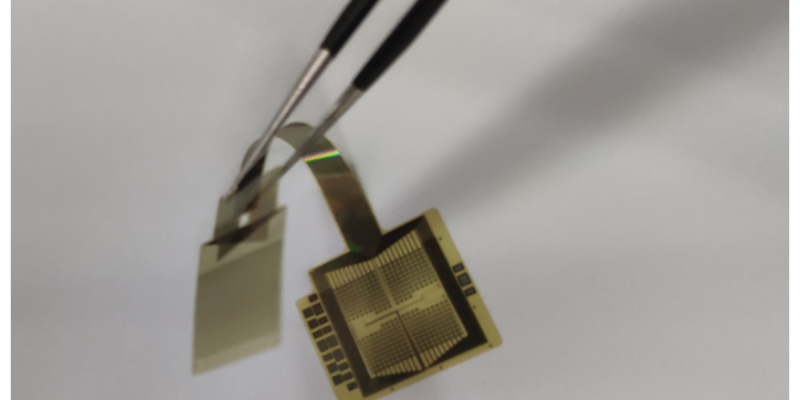
MEMS制作工藝ICP深硅刻蝕:
在半導體制程中,單晶硅與多晶硅的刻蝕通常包括濕法刻蝕和干法刻蝕兩種方法各有優劣,各有特點。濕法刻蝕即利用特定的溶液與薄膜間所進行的化學反應來去除薄膜未被光刻膠掩膜覆蓋的部分,而達到刻蝕的目的。因為濕法刻蝕是利用化學反應來進行薄膜的去除,而化學反應本身不具方向性,因此濕法刻蝕過程為等向性。
濕法刻蝕過程可分為三個步驟:
1)化學刻蝕液擴散至待刻蝕材料之表面;
2)刻蝕液與待刻蝕材料發生化學反應;
3)反應后之產物從刻蝕材料之表面擴散至溶液中,并隨溶液排出。濕法刻蝕之所以在微電子制作過程中被采用乃由于其具有低成本、高可靠性、高產能及優越的刻蝕選擇比等優點。
但相對于干法刻蝕,除了無法定義較細的線寬外,濕法刻蝕仍有以下的缺點:1)需花費較高成本的反應溶液及去離子水:2)化學藥品處理時人員所遭遇的安全問題:3)光刻膠掩膜附著性問題;4)氣泡形成及化學腐蝕液無法完全與晶片表面接觸所造成的不完全及不均勻的刻蝕 自動化檢測系統基于機器視覺,實現微流控芯片尺寸測量、缺陷識別與統計分析一體化。哪里有MEMS微納米加工常見問題
基于 0.35/0.18μm 高壓工藝的神經電刺激 SoC 芯片,實現多通道控制與生物相容性優化。福建MEMS微納米加工貨源充足
MEMS四種刻蝕工藝的不同需求:
1.體硅刻蝕:一些塊體蝕刻些微機電組件制造過程中需要蝕刻挖除較大量的Si基材,如壓力傳感器即為一例,即通過蝕刻硅襯底背面形成深的孔洞,但未蝕穿正面,在正面形成一層薄膜。還有其他組件需蝕穿晶圓,不是完全蝕透晶背而是直到停在晶背的鍍層上。基于Bosch工藝的一項特點,當要維持一個近乎于垂直且平滑的側壁輪廓時,是很難獲得高蝕刻率的。因此通常為達到很高的蝕刻率,一般避免不了伴隨產生具有輕微傾斜角度的側壁輪廓。不過當采用這類塊體蝕刻時,工藝中很少需要垂直的側壁。
2.準確刻蝕:精確蝕刻精確蝕刻工藝是專門為體積較小、垂直度和側壁輪廓平滑性上升為關鍵因素的組件而設計的。就微機電組件而言,需要該方法的組件包括微光機電系統及浮雕印模等。一般說來,此類特性要求,蝕刻率的均勻度控制是遠比蝕刻率重要得多。由于蝕刻劑在蝕刻反應區附近消耗率高,引發蝕刻劑密度相對降低,而在晶圓邊緣蝕刻率會相應地增加,整片晶圓上的均勻度問題應運而生。上述問題可憑借對等離子或離子轟擊的分布圖予以校正,從而達到均鐘刻的目的。 福建MEMS微納米加工貨源充足